PRODUCTS
ThetaMetrisis 膜厚量測/鍍膜量測
ThetaMetrisis 是 NCSR「Demokritos」微電子研究所的衍生公司,於 2009 年在希臘雅典成立。該公司專門開發和製造用於對各個領域的塗層進行精確、快速和無損特性的先進工具。
ThetaMetrisis 為全球的工業和研究組織提供服務,是尖端測量解決方案的值得信賴的合作夥伴。 其創新核心是白光反射光譜法 (WLRS),這是一項突破性的技術,可同時精確測量堆疊薄膜和厚膜的厚度和折射率。
該技術提供了令人印象深刻的測量範圍,從埃(Å)到公釐(mm),可滿足各種應用和行業的需求。
薄膜厚度計是一種用於測量無法用尺測量的非常薄的塗層(例如油漆和薄膜)厚度的儀器。 根據用途,薄膜厚度不能太厚或太薄,因此需要檢查薄膜是否達到適當的厚度。
ThetaMetrisis 薄膜厚度測量儀採用反射光譜法進行測量。此儀器操作簡便,可實現高精度、非接觸式、快速的測量。





ThetaMetrisis 的薄膜厚度計是一種使用「反射光譜法」的測量儀器。
[什麼是反射光譜? ]
反射光譜法涉及將光垂直照射到被測物體上,並透過光譜測量反射光。
與用於比較反射光譜的光譜橢圓偏光儀相比,它不需要特殊技能,易於使用,並且可以快速測量。
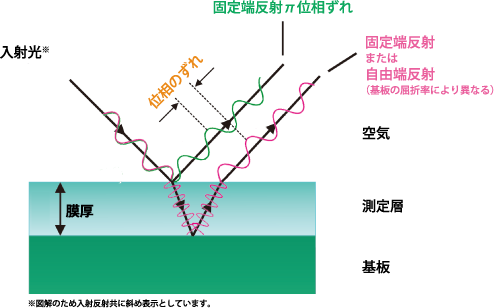
ThetaMetrisis膜厚儀(反射光譜法)應用領域
.png)
效能及特性實例介紹
ThetaMetrisis 為全球的工業和研究組織提供服務,是尖端測量解決方案的值得信賴的合作夥伴。 其創新核心是白光反射光譜法 (WLRS),這是一項突破性的技術,可同時精確測量堆疊薄膜和厚膜的厚度和折射率。
該技術提供了令人印象深刻的測量範圍,從埃(Å)到公釐(mm),可滿足各種應用和行業的需求。
薄膜厚度計是一種用於測量無法用尺測量的非常薄的塗層(例如油漆和薄膜)厚度的儀器。 根據用途,薄膜厚度不能太厚或太薄,因此需要檢查薄膜是否達到適當的厚度。
ThetaMetrisis 薄膜厚度測量儀採用反射光譜法進行測量。此儀器操作簡便,可實現高精度、非接觸式、快速的測量。





ThetaMetrisis 的薄膜厚度計是一種使用「反射光譜法」的測量儀器。
[什麼是反射光譜? ]
反射光譜法涉及將光垂直照射到被測物體上,並透過光譜測量反射光。
與用於比較反射光譜的光譜橢圓偏光儀相比,它不需要特殊技能,易於使用,並且可以快速測量。
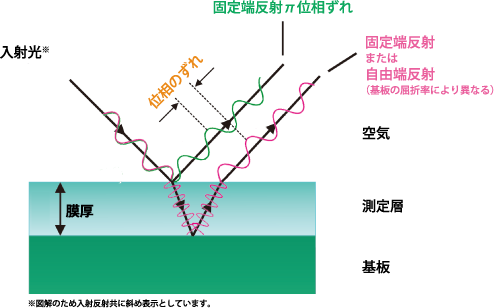
ThetaMetrisis膜厚儀(反射光譜法)應用領域
應用領域:電子材料研發、薄膜在線量產工藝、半導體晶圓、汽車天窗、鏡片、手錶、工具等
.png)
.png)
.png)
.png)
.png)
.png)
反射光譜法可測量的條件
如果滿足以下三個條件,則可以使用反射光譜法:
- 1.允許光線穿過的透明或半透明材料
2.基材與薄膜的折射率有差異
3.薄膜或基材的表面光滑,接近鏡面
(如果在影像中看不到自己的臉,則表面粗糙)。
.png)
有些東西是反射光譜法無法測量的。
反射光譜法無法測量以下情況,因此採用其他測量方法。- 案例研究
- 其他方法(測量原理)
- 膜厚5nm(奈米)以下
- 使用AFM、SEM、橢圓儀進行橫斷面觀察
- 薄膜不透光
- 步距規、干涉儀、雷射顯微鏡、渦流式、螢光X射線
- 測量區域太粗糙
- 步距規、雷射顯微鏡、渦流式(噴砂處理、髮絲等)
效能及特性實例介紹
可以同時測量多層膜厚度和光譜反射率
- .不僅可以測量單層厚度,還可以測量多層厚度
- .為海外產品提供由Restar公司系統工程師開發的中*、日文原生軟體 (*簡體中文)
- 我們致力於簡化操作,並持續更新至最新版本
- 還能靈活應對「我想添加此功能」等客製化需求。 - .不僅測量出的膜厚,膜厚測量結果也以圖表形式顯示,讓您直觀地掌握膜厚的變化
和趨勢。

可分析光學常數(n、k)/導入光學常數
- .不僅可以測量薄膜厚度,還可以分析光學常數(n,k)
- .可導入其他測量儀器(如光譜橢偏儀)測得的光學常數(n,k),
利用導入的光學常數(n,k)可以測量薄膜厚度。 
模擬模式/光譜比較功能- .包含模擬模式
- 如果在基板上沉積一定厚度的某種材料,會得到什麼樣的光譜反射光譜? - 可以繪製理論光譜反射波形光譜。
例 1) 如果 Si 基板上的 SiO2 膜厚度為 1000 nm,會得到什麼樣的反射光譜?
例 2) 我想測量蒸發鋁膜的厚度,但我想模擬可以測量的厚度。
例 3) 在 PET 薄膜上沉積折射率為 1.6 的材料至厚度 70 nm。我想確認是否可以測量這個膜厚度。
例 4) 我想知道可以測量 Si 基板上自然氧化膜的厚度,並將其與沒有自然氧化膜的只有 Si 的理論波形進行比較。
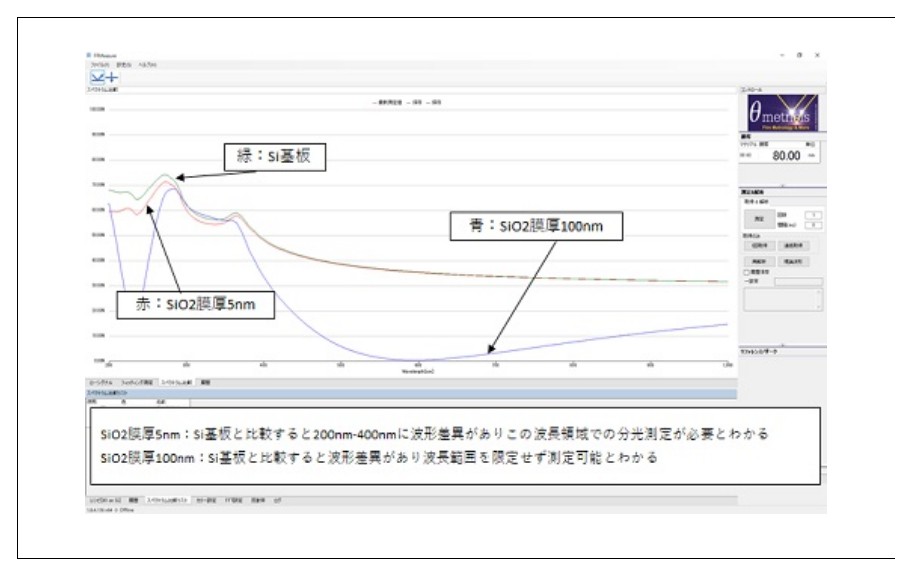
警報功能/操作員模式
如果測量到意外的膜厚,則會發出警報並自動記錄測量值。- 在操作員模式下,可以進行薄膜厚度測量和記錄,而無需分包商或兼職工人
了解您的技術資訊。

還可以測量球面和曲面
接觸式探針模式:能夠測量
不平整表面(例如透鏡球面或碗內)的膜厚。
每次測量後,透過插入和移除接觸式探針,膜厚測量值都會自動記錄,因此無需書寫工具。

可安裝在各種量產線上





